
|
BMe Kutatói pályázat |

|
Villamosmérnöki és Informatikai Kar\Elektronikai Technológia Tanszék
Felületi Hibajelenségek Elektronikus Rendszerekben
A kutatási terület néhány soros bemutatása
Egy Európai Uniós direktíva
(Restriction of Hazardous Substances: RoHS irányelv) nyomán megjelentek az
ólommentes forrasztás irányába mutató gyártási trendek, melyek sokféle
anyagú kontaktusfelületet és a hagyományos ólmos forrasztásétól eltérő
technológiai beállításokat alkalmaznak. Az újszerűségből eredően, különböző
megbízhatósági problémákkal találkozhatunk, ami újabb és újabb kihívások elé
állítja a kutatót. A számos megoldandó problémakörből alapvetően két
kutatási területre koncentrálunk: ón „whisker” tűkristályképződésre és az
elektrokémiai migráció jelenségére, melyek mindkét esetben veszélyes
meghibásodásokhoz (rövidzárlat) vezethetnek. Egy
autó-elektronikai áramkör esetében például a fenti jelenségekből eredő meghibásodások akár
katasztrofális kimenetelűek is lehetnek. Az elektrokémiai migráció során
a feszültség alatt lévő vezető-szigetelő-vezető struktúrákon, nedvesség jelenléte
esetén megindul a fémek ionizációja, és ez vezető fémszálak (dendrite)
növekedéséhez vezet (lásd 1. ábra), míg a whisker-növekedést, a különböző
technológiai és környezeti hatások által előidézett mechanikai feszültségek
okozzák.
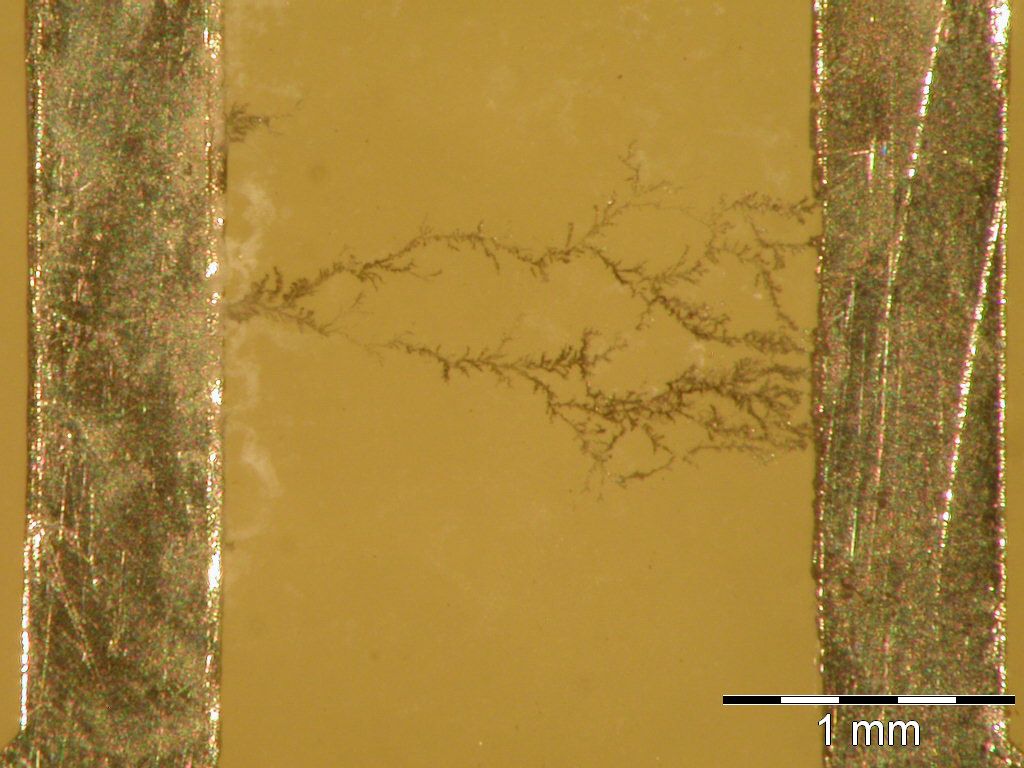
A kutatóhely rövid bemutatása
A kutatóhely - igazodva a tanszéki küldetéshez - alapvetően mikroáramköri és nagy rendszerek közötti fizikai összeköttetések anyagi és technológiai kutatásaira specializálódott, amelyeknél elsősorban gyártástechnológiai, minőségi és megbízhatósági ismereteket használunk fel. Az elektronikai iparban jelentkező igények, a miniatürizáció, az integráltság fokozódása, a vezetőrétegek növekvő sűrűsége és a csökkenő osztástávolságú alkatrészlábak megjelenése miatt egyre kisebb és kisebb felületeken kell a vizsgálatokat elvégezni. A kutatóhely ennek okán olyan műszerparkkal van felszerelve, ami az emberi léptéktől a nano méretekig képes szilárd fázisú vezető, szigetelő és félvezető struktúrákon is vizsgálatokat végezni, sőt bizonyos esetekben a folyadék fázisú mérések is kivitelezhetők. Ezek megvalósításához rendelkezünk optikai mikroszkópokkal (Olympus SZX9 és BX51), röntgenmikroszkóppal (Dage XiDAT 6600), pásztázó elektronmikroszkóppal (FEI Inspect S50) kiegészítve energiadiszperzív röntgen-spektroszkópiára alkalmas egységgel (Bruker Quanta EDX), pásztázó akusztikus mikroszkóppal (Sonix HS 1000), röntgenfluoreszcens spektrofotométerrel (Spectro Midex M), valamint atomerő mikroszkóppal (Veeco diInnova). Az úgynevezett megbízhatósági vizsgálatok elvégzéséhez különböző klímaállósági kamrák állnak rendelkezésre: gyorsított élettartam vizsgálatra alkalmas kamrák (Tabai Espec gym. EHS-211M és Weiss gym. WK 180/40: 2. ábra), illetve egy hősokk kamra (Tabai Espec gym. TSE-11-A).

A kutatás történetének, tágabb kontextusának bemutatása
Az elektrokémiai migráció klasszikus modelljét már az ötvenes években megalkották az ezüst migrációjával kapcsolatban, amely rendszeresen okozott meghibásodási problémákat az elektronikus alkatrészekben és áramkörökben. A modell szerint a jelenség az áramkör működése közben, nedvesség és elektromos feszültség együttes hatására lép fel, és a lényege fémionok keletkezése anódos oldódás révén, ezek vándorlása az elektrolitban, végül az ezt követő dendrites kiválás a katódon. A dendritek átnövése rövidzárak kialakulásához és az áramkör katasztrofális meghibásodásához vezet. A jelenség elsősorban akkor veszélyes, amikor az élet- és vagyonbiztonsági kívánalmaknak megfelelően nagy megbízhatóságúnak vélt rendszerekben idéz elő katasztrofális meghibásodást. További óriási probléma, hogy a meghibásodás hirtelen következik be, általában a környezeti feltételek megváltozása esetén (pl.: páratartalom-növekedés, nedvesség, illetve szennyeződések bekerülése, stb.), ezért annak valószínűségét megjósolni nehéz. Az elektrokémiai migrációs viselkedést hosszú ideig az ezüst egyedüli tulajdonságának tartották, és ennek megfelelő magyarázatok születtek. A későbbi gyakorlati tapasztalatok bebizonyították, hogy egy általánosabb modellről, illetve viselkedésről van szó, hiszen számos más fémkomponens, például a réz, az ólom, az ón is mutat zárlatokhoz vezető migrációt. Ionos szennyeződés jelenlétében ez a zárlatképződési mechanizmus jelentősen változhat. Emellett az újabb és újabb anyagrendszerek megjelenése is folyamatosan igényelte a jelenségkör mélyebb vizsgálatát. Az utóbbi években született, a témát érintő publikációk nagy száma is jelzi a téma aktualitását.
A whisker-képződés jelenségét
először ón felületen fedezék fel szintén az 1950-es években. Miután a
hagyományos ón-ólom tartalmú ötvözetek whisker-képződési folyamatait tisztázták,
igen kevés publikáció született a témában egészen az 1990-es évek végéig. A
kutatási terület az ólom száműzésére vonatkozó szabályozás szándékával (RoHS) újra megpezsdült, mert az
újszerű anyagok alkalmazása számos területen ónkristály-képződési problémához
vezetett (lásd 3. ábra). Mára már számos vállalat napi problémaként küzd a
whisker-képződés ellen.

A kutatás célja, a megválaszolandó kérdések
Az ólommentes forrasztás bevezetése miatt megjelenő sokféle anyagú kontaktusfelület és a technológiai változtatások eredményeként ismét előtérbe került az ón whisker- (ón tűkristály) növekedés hibajelenség (lásd képen), és hangsúlyos maradt az elektrokémiai migráció kutatása is.
Mindkét hibajelenség esetén rövidzárveszély lép fel, ami jelentősen csökkenti a napjainkban egyre finomabb felbontású áramköreink élettartamát. Bár a fenti folyamatok jellemzően nem a nanométeres mérettartományban játszódnak le, a hozzájuk kapcsolódó transzportjelenségek a nanofizika eszköztárával tárgyalhatók. A felületek anyagtudományi vizsgálata is segít a whisker-növekedés leírásában, amelyre a mai napig nincs kielégítő, teljeskörű magyarázat. A whisker kutatásának célja a kiváltó és befolyásoló tényezők feltérképezése és előfordulási valószínűségének csökkentése. Az ón whisker növekedését kiváltó környezeti hatások (hőmérséklet, páratartalom, oxidáció, stb.) mechanizmusának kutatása, a whisker növekedését gátló köztes rétegek (nikkel, ezüst, stb.) és ötvöző anyagok szerkezeti vizsgálata, valamint a whiskerek növekedéséért részben felelős intermetallikus rétegek és az ón réteg szemcsestruktúrájának feltérképezése áll a kutatások fókuszában. Az elektrokémiai migráció kutatásai különböző áramköri hordozón kialakított eltérő kontaktusfelületek és forraszanyagok elektrokémiai tulajdonságainak szoba és extrém klimatikus körülmények között történő vizsgálatára irányulnak, amihez további cél a jelenlegi vizsgálati módszerek fejlesztése, újszerű megfigyelési és mérési módszerek kidolgozása.
Módszerek
A fenti két hibajelenség kutatására elsősorban megbízhatósági (klíma, illetve környezeti terhelés-állósági) vizsgálatokat végeznek, de az elektrokémiai migráció esetében manapság már egyre elterjedtebben alkalmaznak ún. vízcsepp tesztet. A vízcsepp teszt lényege, hogy egy (űrtartalom, koncentráció vonatkozásában) jól definiált folyadék (leginkább desztillált víz) -cseppet helyezünk (szobahőmérsékleten) a vizsgálandó vezetőrétegek közé, és néhány volt (DC) feszültséget kapcsolunk a rendszerre. Közben vizuálisan figyeljük a fémszálak (dendritek) kialakulását és a kialakulás sebességét, illetve például a szivárgási áram időfüggését. Ez tulajdonképpen egy rendkívül durva beavatkozási módszer, viszont kvalitatív megfigyelésre jól alkalmazható. A módszer előnye, hogy könnyen és gyorsan megállapítható egy kérdéses anyag elektrokémiai migrációs hajlamossága.
A megbízhatósági vizsgálatok esetén a mintákat klímakamrában a szobahőmérsékletnél magasabb hőmérséklet és/vagy magas relatív páratartalom együttes igénybevételének vetik alá. Ez egy általánosan elterjedt eljárás az elektronikában olyan „öregedési” folyamatok vizsgálatánál, melyeket a fenti tényezők együttesen vagy külön-külön befolyásolhatnak. Kvalitatív megfigyelésre ez kevésbé alkalmas. Kvantitatív összehasonlítás úgy lehetséges, hogy a különböző mintákat azonos körülmények (relatív páratartalom, hőmérséklet, villamos terhelés) között tartva figyeljük a villamos paraméterek (például szigetelési ellenállás, vagy a szivárgási áram időfüggése) változását.
A megbízhatósági vizsgálatok és a vízcsepp tesztek mellett felületanalizáló módszerek alkalmazása is szükséges. A minták felületét elsősorban pásztázó elektronmikroszkóppal (SEM) vizsgáljuk. Ilyenkor a felület feltérképezése, illetve domborzati megjelenítése a cél, és ennél akár 100000x-es nagyítás is elérhető. Az EDX (Energy-dispersive X-ray spectroscopy) módszer segítségével a felületi részek anyagösszetétele, illetve elemtérképe is meghatározható. Az EDX tulajdonképpen egy kiválasztott ponton vagy területen lévő anyag összetételének meghatározására alkalmas mérési módszer, ami akár tömeg- vagy atomarányt is ki tud mutatni.
A rétegek keresztmetszeti feltárására FIB (Focused ion beam) eljárást alkalmazunk (japán partnerek (NIMS) segítségével), ahol fókuszált ionsugárral maratást végzünk a mintán. Ez a keresztmetszeti struktúráról ad bővebb információt, ily módon vizsgálható például a rétegek szemcseszerkezete is. A szemcsék orientációját valamint azok elemösszetételét pedig transzmissziós elektronmikroszkóppal (TEM) vizsgáljuk, ami már valóban a nanométeres tartományt jelenti.
Eddigi eredmények
Az alapvető célkitűzésünk az volt, hogy több információt nyerjünk az elektrokémiai migrációval kapcsolatban. Ezért kifejlesztettünk egy olyan újszerű megfigyelő rendszert, amelynek segítségével extrém körülmények között (magas hő és pára) „in-situ” és „real-time” figyelhetjük meg a víz kondenzációs folyamatát és az utána következő zárlatképződést a különböző felületi vezető-szigetelő-vezető struktúrákon. A mérőrendszer verifikálására egyrészről egy villamos jel változását mértük, illetve videofelvételek rögzítésével információt kaptunk a víz lecsapódásáról, és ezt követően nyomon követtük a dendritek kialakulását is. Megfigyelhető volt, amint a fémeken megindult az intenzív kondenzáció, kezdetben apró cseppecskék formájában, majd hirtelen a cseppek összefolytak és a kis víz „szigetek”-ből folytonos nedvességfilm alakult ki, amely esetenként a felületi vezető-szigetelő-vezető struktúrán hídalt át. Ezek után indult meg az ún. dendritképződés (fémszál növekedés), amely végül zárlathoz vezetett. Ez a megfigyelés azért volt fontos, mert rávilágított arra, hogy a klímakamrában végbemenő zárlatképződési folyamatok jobban modellezik a meghibásodási mechanizmust, mint vízcsepptesztes módszer. Ez utóbbi ugyanis figyelmen kívül hagyja a páralecsapódás mechanizmusát, amely eltérő vezető-szigetelő-vezető struktúrákon feltehetőleg más és más idő alatt megy végbe.
Whisker-kutatásunk elsődleges célja a növekedési mechanizmus elemzése, és ki kell dolgoznunk olyan új stratégiákat, amelyek a növekedési mechanizmust meggátolják vagy legalább lassítják. Tanulmányozzuk továbbá ezen lassító és/vagy gátló mechanizmusok hatását is. A megfigyelések alapján (réz és ón réteg közötti) köztes rétegek alkalmazásával mérsékelhető a whisker-képződés jelensége. Ezek a fémes köztes rétegek meggátolják a Cu6Sn5 intermetallikus réteg kialakulását, amely egyébként nagy mechanikai feszültséget okozna a réz és az ón réteg határán, ami az ón tűkristály-képződés előidézője. Vizsgálataink során nikkel és ezüst köztes réteget alkalmaztunk különböző megbízhatósági teszt paraméterek mellett. A vizsgálatok másik célkitűzése az, hogy az ón rétegen kialakuló oxid réteg hatásait vizsgáljuk whisker-képződés szempontjából. Fontos felfedezés volt, amikor az ezüst köztes réteggel ellátott mintákon 105°C/100%RH beállítású megbízhatósági vizsgálatot végezve nagyon sűrű, de viszonylag rövidere nőtt whiskerek képződését tapasztaltuk, amelyeknek oka, hogy a nedvesség következtében fellépő oxidációs folyamat meggátolta a tűkristályok további növekedését. Foglakoztunk ezen kívül az úgynevezett „interdiffúziós” jelenség köztesrétegre gyakorolt hatásaival is, ahol a mechanikai feszültség hatására ébredő erők szintén komoly befolyással bírnak a whisker-képződésre.
Várható impakt, további kutatás
Az Sn-Ag és Sn-Ni esetén fellépő interdiffúziós jelenséggel kapcsolatban például alig olvasható tudományos publikáció, és a közölt eredmények is vitathatóak. Ha az ón rétegbe rezet juttatunk ötvözőként, akkor akár jelentősen mértékben is változhat a korróziós ellenállás, vagy a whisker-képződési mechanizmus. Az ilyenkor szokásos felületanalitikai módszerek (optikai, elektron- és röntgen-mikroszkópiák) alkalmazásán túl elektrokémiai mérési módszereket is bevetnénk a korróziós folyamatok whisker-képződésre gyakorolt hatásának jobb megértése érdekében. Az ón, illetve az ónoxidos whiskerek területén lévő számos nyitott kérdés fontos kutatási lehetőségeket rejt magában, amitől hasznos, értékelhető eredményeket várhatunk az anyagtudomány és az elektronikai ipar számára is.
Az ólommentes forrasztás bevezetésével az elektrokémiai migráció újra az elektronikai áramkörök, egységek és szerelvények megbízhatóságának egyik központi témája lett. Az új anyagokat különböző hordozókra, különböző technológiákkal hordják fel, és az így készült áramköröket igen változatos környezeti körülmények között üzemeltetik. Ez önmagában akkora kihívás, amely az elkövetkezendő évek kutatásait biztosan jelentős mértékben kitölti. Az elektrokémiai migrációs hajlam ugyanis számos tényezőtől függ (a teljesség igénye nélkül): a hordozó anyagai (porózusság, nedvszívó képesség), a kontaktusfelületek anyagai és azok felviteli eljárásai, a vezetősávok hídtávolsága, üzemi feszültség, a nedvesség megjelenésének módja és annak mennyisége, valamint a felületi, illetve nedvesség-szennyezők típusa, illetve azok koncentrációja, stb. A fentiek alapján elsőként ólommentes forraszok migrációs viselkedését vizsgáljuk különböző hordozókon, illetve különböző forrasztási eljárások esetén.
A kutatások eredményeitől azt várjuk, hogy hasznos információt fognak adni az elektronikai ipar számára; a gyártásnál például segíthetnek a megfelelő anyagválasztásban és a technológiai paraméterek optimális beállításában, ami magasabb minőségi és megbízhatósági szintet eredményez a termék teljes életciklusát tekintve.
Saját publikációk, hivatkozások, linkgyűjtemény
Az elmúlt 5 év jelentősebb publikációi:
Bálint Medgyes, Balázs Illés, Richárd Berenyi, Gábor Harsányi, In situ optical inspection of electrochemical migration during THB tests, JOURNAL OF MATERIALS SCIENCE-MATERIALS IN ELECTRONICS 22:(6) 694–700. (2011) IF: 1.020*, teljes dokumentum, teljes dokumentum a kiadónál, DOI: 10.1007/s10854-010-0198-4
Bálint Medgyes, Balázs Illés, Gábor
Harsányi, Electrochemical Migration Behaviour of Cu, Sn, Ag and Sn63/Pb37, JOURNAL OF MATERIALS SCIENCE-MATERIALS IN ELECTRONICS, sajtóban, DOI: 10.1007/s10854-011-0435-5, IF:
1.020*
B Illés, B Horváth, G Harsányi,
Effect of strongly oxidizing environment on whisker growth form tin coating.
SURFACE & COATINGS TECHNOLOGY 205: 2262–2266. (2010) IF: 1.793*, WoS link, DOI: 10.1016/j.surfcoat.2010.09.012
Barbara Horváth, T Shinohara, Balázs Illés, Gábor Harsányi, Tin Whisker Growth at High Humidity Environments – Investigated on Ni and Ag Underlayered Leadframes, 57th Materials and Environment Debate. Okinawa, Japán, 2010.10.20-2010.10.22. 304–307. Paper C-301.
Barbara Horváth, Balázs Illés,
Gábor Harsányi, Investigation of tin whisker growth: The effects of Ni and Ag
underplates, Megjelent: 32th Spring Seminar on Electronics Technology. Brno,
Csehország, 2009.05.13-2009.05.17. (IEEE) Brno: 1-5. Paper D07, DOI: 10.1109/ISSE.2009.5207031
Az elmúlt 5 évet megelőző jelentősebb publikációk:
Harsányi G, Inzelt Gy, Comparing Migratory Resistive Short Formation Abilities of Conductor Systems Applied in Advanced Interconnection Systems, MICROELECTRONICS AND RELIABILITY 41: 229–237. (2001) IF: 0.548, WoS link
Harsányi Gábor, Irregular Effect of Chloride Impurities on Migration Failure Reliability: Contradictions or Understandable? MICROELECTRONICS AND RELIABILITY 39: 1407–1411. (1999) IF: 0.374, WoS link
Harsányi Gábor, Copper May Destroy
Chip-Level Reliability: Handle with Care – Mechanism and Conditions for Copper
Migrated Resistive Short Formation, IEEE ELECTRON DEVICE
LETTERS 20:(1) 5–8. (1999) IF: 3.018, WoS link
Harsányi Gábor, Material Design Aspects of High Reliability high Density Interconnects, MATERIALS CHEMISTRY AND PHYSICS 45: 120–123. (1996) IF: 0.583
Harsányi Gábor, Electrochemical Processes Resulting in Migrated Short Failures in Microcircuits, IEEE TRANSACTIONS ON COMPONENTS PACKAGING AND MANUFACTURING TECHNOLOGY PART A 18:(3) 602–610. (1995) IF: 0.179, WoS link
Linkgyűjtemény:
http://mycite.omikk.bme.hu/search/slist.php?lang=0&AuthorID=10001333
http://mycite.omikk.bme.hu/search/slist.php?lang=0&AuthorID=10001162
http://mycite.omikk.bme.hu/search/slist.php?lang=0&AuthorID=10005055
http://mycite.omikk.bme.hu/search/slist.php?lang=0&AuthorID=10005593
Résztvevők bemutatása:
Prof. Dr. Harsányi Gábor
A Magyar Tudományos Akadémia Doktora, jelenleg a Budapesti Műszaki és Gazdaságtudományi Egyetem, Elektronikai Technológia Tanszék vezetője. Kutatási területe: hibrid áramkörök, multichip modulok, szenzor technológia
dr. Illés Balázs
Okleveles villamosmérnök, PhD, jelenleg a Budapesti Műszaki és Gazdaságtudományi Egyetem, Elektronikai Technológia Tanszékén dolgozik adjunktusként. Kutatási területe: forrasztási mechanizmusok modellezése és optimalizálása és az ón whisker kialakulási mechanizmus vizsgálata
Horváth Barbara
Okleveles villamosmérnök, jelenleg harmadéves doktorandusz a Budapesti Műszaki és Gazdaságtudományi Egyetem Villamosmérnöki karán. Kutatási területe: az ón whisker kialakulási mechanizmusa, nyomtatott huzalozású lemezek.
Medgyes Bálint
Okleveles mérnök-közgazdász, jelenleg kutató mérnökként dolgozik a Budapesti Műszaki és Gazdaságtudományi Egyetem, Elektronikai Technológia Tanszékén. Kutatási területe: Minőségbiztosítás és megbízhatóság, elektrokémiai migráció.
 |
 |
 |
 |
|
Prof.
Dr. Harsányi
Egyetemi tanár |
dr.
Illés Balázs Adjunktus |
PhD hallgató |
Tanszéki mérnök |
