 |
BMe Kutatói pályázat |

|
Villamosmérnöki Tudományok Doktori Iskola
Elektronikai Technológia Tanszék/ Villamosmérnöki és Informatikai Kar
Témavezető: Prof. Harsányi Gábor
Az elektrokémiai migráció egyes kérdései összeköttetés-hálózatokban
A kutatási téma néhány soros bemutatása
Kutatómunkám fókuszában az elektrokémiai migráció hibajelenségének tanulmányozása áll, azzal az általános célzattal, hogy elősegítsem nagyobb megbízhatóságú áramkörök megvalósítását. Az elektrokémiai migráció során (villamos terhelés alatt lévő vezető-szigetelő-vezető struktúrákon) nedvesség jelenléte mellett a fém vagy ötvözet ionos beoldódása indul meg az anódon, majd a migráció után fémionok redukálódnak a katódon, és ez vezető fémszálak (dendritek) kialakulásához vezet (1. ábra). Egy járműipari áramkörre gondolva, például a hibajelenségből eredő meghibásodás akár katasztrofális kimenetelű is lehet.
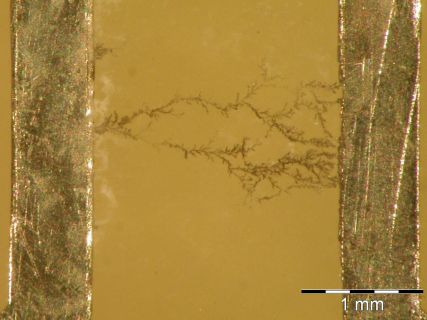
1. ábra. Zárlatot okozó dendrit
A kutatóhely rövid bemutatása
A kutatóhely - igazodva a tanszéki küldetéshez - alapvetően mikroáramköri és nagy rendszerek közötti fizikai összeköttetések anyagi és technológiai kutatásaira specializálódott, amelyeknél elsősorban gyártástechnológiai, minőségi és megbízhatósági ismereteket használunk fel. Az elektronikai iparban jelentkező igények: a méretcsökkentés, az integráltság fokozódása, a vezetőrétegek növekvő sűrűsége és a csökkenő osztástávolságú alkatrészlábak megjelenése miatt egyre kisebb és kisebb felületek kerülnek górcső alá. A kutatóhely emiatt olyan műszerparkkal van felszerelve, amely az emberi léptéktől a nano méretekig képes vizsgálatokat végezni szilárd fázisú vezető, szigetelő és félvezető struktúrákon is, sőt bizonyos esetekben a folyadék fázisú mérések is kivitelezhetők. Ezek megvalósításához rendelkezünk optikai mikroszkópokkal (Olympus SZX9 és BX51), röntgen mikroszkóppal (Dage XiDAT 6600), energiadiszperzív röntgen-spektroszkópiára alkalmas egységgel (Bruker Quanta EDX) kiegészített pásztázó elektronmikroszkóppal (FEI Inspect S50), pásztázó akusztikus mikroszkóppal (Sonix HS 1000), röntgenfluoreszcens spektrofotométerrel (Spectro Midex M), valamint atomerő-mikroszkóppal (Veeco diInnova). A megbízhatósági vizsgálatok elvégzéséhez különböző klímaállósági kamrák állnak rendelkezésre: gyorsított élettartam-vizsgálatra alkalmas kamrák (Tabai Espec; EHS-211M és Weiss; WK 180/40) (lásd 2. ábra), ill. egy hősokk kamra (Tabai Espec, TSE-11-A).

2. ábra. Hő- és párakamra
A kutatás történetének, tágabb kontextusának bemutatása
Manapság az elektronikai iparban gyártott szerelvények, áramköri egységek jelentős részével szemben egyre magasabb megbízhatósági és minőségi követelményeket támasztanak, hiszen az egységnyi felületen a méretcsökkenésből adódóan az alkatrészek száma drasztikusan nő, ennek következtében a vezetéksűrűség is fokozódik, ami nyilvánvalóan a meghibásodás valószínűségét is növeli. A megbízhatósági kérdéseket tekintve elsősorban a forrasztási felületeket, illetve a forrasztott kötések anyagrendszereit, azok fizikai és kémiai tulajdonságait vizsgálják. A feladatok összetettségét tovább növeli, hogy a 2006-ban hatályba lépett „Restriction of Hazardous Substances” (RoHS) direktíva [1] nyomán megjelentek az ólommentes forrasztás irányába mutató elektronikai gyártási trendek. Ezek számos különböző, új anyagrendszerű kontaktusfelületet és a hagyományos ólomtartalmú forrasztásétól eltérő technológiai beállítást alkalmaznak. Az újszerűségből eredően újabb és újabb megbízhatósági problémákkal találkozhatunk. Ilyen kurrens probléma az elektrokémiai migráció jelensége is [2,3].
Az elektrokémiai migráció klasszikus modelljét már az 1950-es évek elején megalkották az ezüst migrációjával kapcsolatban, amely rendszeresen okozott meghibásodási problémákat az elektronikus alkatrészekben és áramkörökben [4]. A modell szerint a jelenség az áramkör működése közben, nedvesség és elektromos feszültség együttes hatására lép fel, lényege fémionok keletkezése anódos oldódás révén, ezek vándorlása az elektrolitban, és az ezt követő dendrit-kiválás a katódon. A dendritek átnövése rövidzárak kialakulásához és az áramkör esetenként veszélyes meghibásodásához vezethet. A jelenség elsősorban akkor veszélyes, amikor az élet- és vagyonbiztonsági kívánalmaknak megfelelően nagy megbízhatóságúnak vélt rendszerekben idéz elő katasztrofális meghibásodást. További óriási probléma, hogy a meghibásodás hirtelen következik be, általában a környezeti feltételek megváltozása esetén (pl.: páratartalom növekedés, nedvesség, ill. szennyeződések bekerülése, stb.), ezért annak valószínűségét előre megjósolni nehéz.
Hosszú ideig az ezüst egyedüli tulajdonságának tartották az elektrokémiai migrációs viselkedést, s ennek megfelelő magyarázatok születtek. A későbbi gyakorlati tapasztalatok bebizonyították, hogy egy általánosabb modellről, ill. viselkedésről van szó, hiszen számos más fémkomponens is mutat zárlatokhoz vezető migrációt, mint például a réz, ólom vagy ón. Ionos szennyeződés jelenlétében ez a zárlatképződési mechanizmus jelentősen változhat. Az újabb és újabb anyagrendszerek megjelenése is folyamatosan igényelte a jelenségkör mélyebb vizsgálatát. Az utóbbi években született jó néhány, a témát érintő publikáció is jelzi a téma aktualitását [5,6].
A kutatás célja, a megválaszolandó kérdések
Az elektrokémiai migráció jelensége napjainkban sok esetben nem teljesen tisztázott folyamatokat, reakciókat takar. A hibajelenség leírására felállított különböző modellek és elméleti megfontolások nem adnak elegendő információt a teljes folyamat megértéséhez. A megértést az is nehezíti, hogy más és más elektrokémiai folyamat játszódhat le például az eltérő anyagrendszerekben, a környezeti szennyeződésektől függően eltérő elektrolit oldatokban vagy eltérő geometriákon. Mivel ez az elektrokémiai folyamat igen kis térfogatokban zajlik, valamint nem stacionárius és nem is homogén elektrokémiai rendszerekről van szó, nem állnak rendelkezésünkre megfelelő leíró egyenletek, és így a modellalkotás is inkább a tapasztalati, kísérleti megfigyelések alapján történik [7].
A megfigyeléseket alapvetően kétféle környezetben végzik. A vizsgálatok egyik részét laboratóriumi körülmények között, szobahőmérsékleten, míg a másik részét extrém klimatikus körülmények biztosításával hajtrák végre. Ez utóbbi vizsgálatokhoz un. klímaállósági vizsgálatokra alkalmas klímakamrákat alkalmaznak, ahol magas hő- és páratartalom mellett követik a tesztstruktúrák valamilyen villamos paraméterének valós idejű vagy diszkrét mérésekkel megvalósított változását.
Az eddigi megfigyelések elsősorban magukra az elektrokémiai migrációs folyamatokra irányultak és viszonylag kevés figyelmet fordítottak az elektrokémiai folyamathoz vezető előzményekre, pl. a páralecsapódásra. Ezek a klímaállósági vizsgálatok jól modellezik ugyan a páralecsapódási szakaszt is, de minimális információ található arról, hogy az elektrokémiai migráció, vagyis a dendritképződési szakasz előtt fizikailag miként zajlik a nedvességlecsapódási folyamat [8].
További nyitott kérdés még, hogy a kondenzáció folyamata, a kondenzációs idő (Mean Time To Condensation: MTTC) mennyire összemérhető az azt követő elektrokémiai migráció által előidézett zárlatképződési mechanizmus idejével (dendritképződési szakasz), vagyis lehetséges, hogy a páralecsapódás bizonyos esetekben nem elhanyagolható tényező a meghibásodásig eltelt idő egészét tekintve (Mean Time To Failure: MTTF).
1. Kutatómunkám egyik alapvető célja volt, hogy elősegítsem az elektrokémiai migráció által okozott meghibásodásokhoz vezető folyamatok jobb megértését. Ezért tisztázni kell azt, hogy az elektrokémiai migráció beindulását megelőző szakaszban milyen folyamatok mennek végbe, és hogy ezek a folyamatok milyen hatással vannak a teljes hibamechanizmusra. Esetemben a nedvesség kondenzációjának optikai és villamos paraméterrel követett vizsgálatát kívántam megvalósítani (FR-4 hordozó, ezüst vezetőpálya példáján) és ehhez egy új mérési módszer kidolgozását tűztem ki célul.
2. További feladat annak a megfigyelése is, hogy az adott struktúrán az összefüggő nedvességréteg kialakulásához szükséges MTTC és a migrációval (az anódos oldódás megindulásától a zárlatokat kialakító dendritek képződéséig) eltelt idő milyen arányban oszlik meg a meghibásodási idő egészét tekintve. Amennyiben bizonyítható, hogy a MTTC idő – bizonyos esetekben – nem elhanyagolható a teljes hibamechanizmusra nézve, akkor a jelenlegi gyorsítási modellek egy része kiegészítésre szorul.
3. Emellett a szakirodalomban is számos tisztázatlan kérdés, illetve ellentmondásos állítás található. Ilyen ellentmondásos leírást lehet találni a réz és az ólom migrációja kapcsán, ahol egy migrációs rangsort állítottak fel: Ag>Pb>Cu>Sn (értsd: az ezüst hibásodik meg leghamarabb) [9]. Ez vizsgálódás tulajdonképpen a különböző forrasztható fémbevonatok anyagválasztásának könnyítését célozza, hiszen nem mindegy, hogy migrációs szempontból egyik másik fémezés mennyire lesz megbízható a működés során.
4. A tisztázatlan területeket tekintve, az újonnan megjelenő ólommentes forraszok elektrokémiai migrációs tulajdonságainak feltárását végzem. Ismeretes például, hogy a hagyományos ólmos forraszokhoz képest igen eltérő megbízhatóságot mutathatnak [10]. A fentiek miatt a kutatások utolsó csoportjában az ólmos és az új ólommentes forraszok összehasonlító és minősítő vizsgálatainak elvégzése a cél, különös tekintettel az elektrokémiai migrációs meghibásodásokra. Az összehasonlítás alapja lehet a felületeken kialakult helyi aktív és passzív cellák feltérképezése (elektrokémiai korrózió), vagy akár a tömbi forraszban kialakult intermetallikus rétegek szerkezetének és anyagösszetételének tanulmányozása is.
Módszerek
A kutatási módszereket érdemes kettéválasztani a környezeti behatások, paraméterek szerint. Az egyik csoportban szobahőmérsékleten (kb. 50% relatív légnedvességnél), míg a másikban extrém klimatikus körülmények biztosításával (klímaállósági vizsgálatok) végzik a kutatásokat.
A klímaállósági vizsgálatok esetén a mintákat klímakamrában a szobahőmérsékletnél magasabb hőmérséklet és/vagy magas relatív páratartalom igénybevételének vetik alá. Ez egy általánosan elterjedt eljárás az elektronikában olyan öregbítési folyamatok vizsgálatánál, melyeket a fenti tényezők együttesen vagy külön-külön befolyásolhatnak, kvalitatív megfigyelésre azonban kevésbé alkalmas. Kvantitatív összehasonlítás úgy lehetséges, hogy a különböző mintákat azonos körülmények (relatív páratartalom, hőmérséklet, villamos terhelés) között tartva villamos paraméterek változását (például szigetelési ellenállás, vagy a szivárgási áram időfüggését) figyeljük.
Az elektrokémiai migráció kutatására nem csak klímaállósági vizsgálatokat végeztek, hanem alkalmaznak szobahőmérsékleten művelhető vizsgálatokat is, mint pl. a vízcsepp tesztet. A vízcseppteszt lényege, hogy egy jól definiált (űrtartalom, koncentráció) folyadék (elektrolit) cseppet helyeznek a vizsgálandó vezetőrétegekre illetve közé és néhány volt feszültséget (DC) kapcsolnak a rendszerre. Közben vizuálisan figyelik a fémszálak (dendritek) kialakulását és a kialakulás sebességét (Mean Time To Dendrite: MTTD), illetve például a szivárgási áram időfüggését. Ez tulajdonképpen egy durva beavatkozási módszer, viszont kvalitatív és kvantitatív megfigyelésre egyaránt alkalmazható. A módszer előnye, hogy könnyen és gyorsan megállapítható egy kérdéses anyag elektrokémiai migrációs hajlamossága, valamint lehetőséget nyújt, más anyagokkal való összehasonlításra. A réz és az ólomtartalmú anyagrendszerek migrációs összehasonlításához elsősorban vízcsepp tesztet alkalmaztam.
A klímaállósági vizsgálatok és a szobahőmérsékleten végzett vízcsepp tesztek eredményeiként kapott mintaszerkezeteken különböző felületanalizáló és rétegszerkezet-vizsgáló módszerek alkalmazása is szükséges a végbement változások értelmezése érdekében. A minták felületét elsősorban pásztázó elektronmikroszkóppal (SEM) vizsgáltam (3. ábra). Ebben az esetben a felület feltérképezése, annak domborzati megjelenítése a cél.

3. ábra Dendrit elektronmikroszkópos felvétele (zöld keret = anyagösszetétel vizsgálati területe)
A felületi részek anyagösszetétele illetve elemtérképe is meghatározható az energiadiszperzív röntgenspektroszkópia (EDS) módszer segítségével. Az EDS tulajdonképpen egy ponton vagy akár meghatározott területen lévő anyag összetételének meghatározására alkalmas mérési módszer, ami akár tömeg- vagy atomarányt is ki tud mutatni (1. Táblázat).
1. Táblázat. Dendrit anyagösszetétele a zöld keretben foglalt terület alapján.
|
Elem |
series |
[norm. tömeg%] |
[norm. atom%] |
Hiba, tömeg% (1 Szigma) |
|
Szén |
K-series |
15,088 |
55,2388 |
2,529146 |
|
Oxigén |
K-series |
5,595984 |
15,38029 |
1,095694 |
|
Ón |
L-series |
79,31601 |
29,38091 |
2,194223 |
|
|
Sum: |
100 |
100 |
|
Alkalmazható még a röntgen fotoelektron-spektroszkópia (XPS) vagy a pásztázó auger mikroszkópia (SAM) módszerek, ahol a felületen kémiailag megkötött elemek kötésállapotai tanulmányozhatók. Az említett felület- és rétegvizsgáló módszerekkel figyeltem meg az egyes dendritek morfológiáját, anyagösszetételét, de a különböző forraszok felületét és azok tömbi szerkezetét is.
Eddigi eredmények
Kifejlesztettem egy olyan új mérési módszert, aminek segítségével extrém körülmények között (magas hő és pára) „in-situ” és „real-time” figyelhetjük meg a víz kondenzáció folyamatát és az utána következő zárlatképződési mechanizmust, különböző felületi vezető-szigetelő-vezető struktúrákon (lásd kapcsolódó publikációk). A mérőrendszer verifikálására egyrészről egy villamos jelváltozást mértem, illetve videofelvételek rögzítésével kvalitatív információt kaptam a víz lecsapódási folyamatáról, majd az azt követő dendritkialakulásról. Megfigyelhető volt, hogy a fémeken megindult intenzív kondenzáció, kezdetben apró cseppecskék formájában jelentkeztek (4. ábra), majd növekedésnek indultak és „szigetekké” alakultak.

4. ábra. A fémen megindult a cseppképződés, a szigetelőn kevésbé látható nedvesség, kondenzációs magvak feltételezhetők.
A kis víz „szigetek”-ből, folytonos nedvességfilm képződött a fémen, e közben a szigetelő részeken még mindig csak magvakban látszódott a kicsapódott nedvesség. Végül a fémen megindult intenzív kicsapódás nyomán létrejövő cseppek, esetenként a felületi szigetelő rétegen hidaltak át (5. ábra).
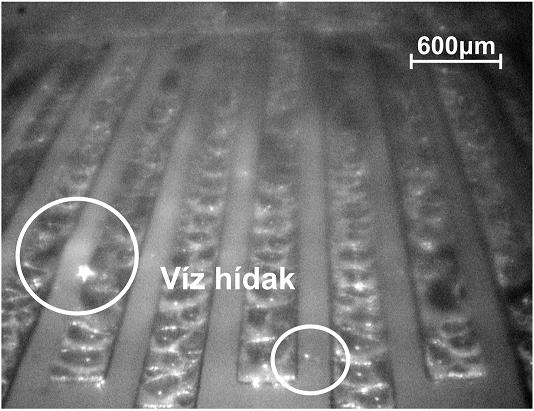
5. ábra. A fémeken akkorára duzzadtak a cseppek, hogy immár áthidalják a szigetelő részeket.
Ezek után indult meg az ún. dendritképződés (fémszálnövekedés), aminek végkifejlete zárlathoz vezetett (6. ábra).
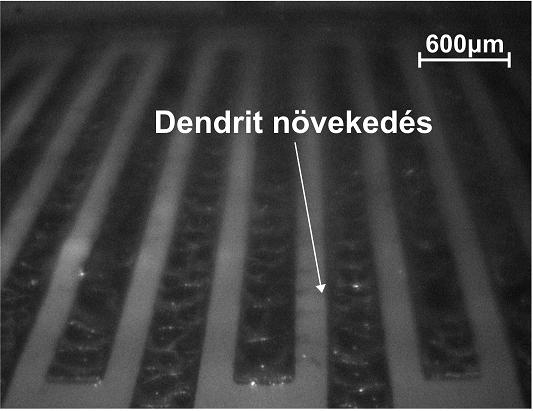
6. ábra. Dendritképződés kezdete, közvetlenül a szigetelő réteg, víz „áthidalása” után.
A szigetelőn un. kapilláris kondenzáció érvényesül [11], ami egyben a szűk keresztmetszetet is jelenti a nedvesség kicsapódásában, pontosabban a folytonos nedvességfilm kialakulásában, amelynek eredményeként a víz hidat képez a vezetők között. Ez a megfigyelés azért volt fontos, mert rávilágított arra, hogy a klímakamrában végbemenő zárlatképződési folyamatok jobban modellezik a meghibásodási mechanizmust, mint vízcsepp tesztes módszer. Ez utóbbi figyelmen kívül hagyja a páralecsapódás mechanizmusát, ami feltehetően eltérő vezető-szigetelő-vezető struktúrákon más és más idő alatt megy végbe. A fentiek alapján kimondhatom a következőt:
Megalkottam egy olyan in-situ valós idejű monitorozó rendszert, amely optikai megfigyelés mellett villamos paraméterek változásának követésével információt szolgáltat klímaállósági vizsgálatok során az elektrokémiai migráció teljes folyamatáról. A módszer alkalmas nemcsak a dendritképződési folyamat, hanem az azt megelőző nedvességkondenzáció megfigyelésére is, ezzel elősegítve a hiba kialakulásának jobb megértését.
A fentiekből sejthető, hogy bizonyos esetekben a MTTC jelentősen módosíthatja a MTTF értékét. Ennek tisztázására olyan mérőlemezeket terveztem, ahol (ceteris paribus) egyetlen egy paramétert változtattam; a hordozó anyagát. Ugyanis, mint írtam, a kapilláris kondenzáció szerepét kell tisztázni a MTTC és az MTTF tekintetében. A vizsgálatokhoz az elektronikai iparban széles körben alkalmazott hordozót, a poliimidet (PI), illetve a legelterjedtebb hordozót, az üvegszál erősítésű epoxi gyantát (FR-4) használtam fel. A lemezek mérőalakzataként szabványos (IPC-B-24) fésűs struktúrát hoztam létre immerziós ezüst bevonattal. Az immerziós ezüst bevonatot ma is elterjedten alkalmazzák az elektronikai iparban forrasztási felületként, és a réz vezető védőbevonataként egyaránt. A laborkörülmények között végzett vízcsepp teszt eredményeivel (kondenzációt nem veszi figyelembe) összevetettem a klímakamrában kapott eredményekkel (kondenzációt figyelembe veszi), hogy megállapítható legyen a kondenzáció hatása (lásd 7-9. ábra). A 7. ábrán látható, hogy a vízcsepp teszt esetén nem volt szignifikáns különbség, és az átlagok 4 másodperc alatt vannak.

7. ábra. Meghibásodásig eltelt idő FR4 és PI-en kialakított iAg struktúra esetén (hiba határ: 100 mVDC), kondenzációs hatás mellőzésével (MTTF=MTTD).
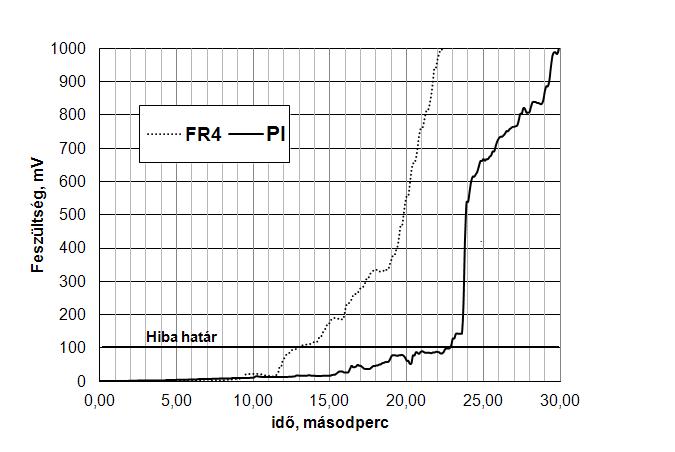
8. ábra. Meghibásodásig eltelt teljes idő (MTTF) különbség FR-4 és PI hordozó között kondenzációs hatás figyelembevételével.
A 8. ábra szignifikáns, kb. 10 másodperces különbséget mutat a hibahatár figyelembe vételével, de a hordozók külön-külön is szignifikáns MTTF-eltérést mutatnak a WD tesztes eredményekhez képest (lásd 9. ábra).

9. ábra. A meghibásodásig eltelt idő alakulása WD illetve THB tesztek esetén (32 db mérés tesztenként).
A fenti eredmények figyelembe vételével a következő volt kimondható:
Az in-situ valós idejű mérési módszer segítségével kimutattam, hogy a kondenzációs idő (MTTC) nem elhanyagolható a meghibásodásig eltelt idő egészét (MTTF) tekintve akkor, ha csak a hordozó anyagában van különbség (FR-4 vs. Poliimid esetén) és minden más paraméter megegyezik, valamint a vezetőpálya anyaga ezüst. Ezért az ezüst migrációs meghibásodásokra alkalmazott gyorsítási modellek kiegészítésre szorulnak a fenti feltételek figyelembevételével:
MTTF = MTTC + MTTD
A kutatómunka további célkitűzése az volt, hogy a szakirodalomban található egyes tisztázatlan kérdésekre és hibás következtetésekre rávilágítsak, valamint kielégítő választ adjak azokra. Ilyen ellentmondásos helyzetet lehet találni a réz és az ólom migrációja kapcsán, ahol egy migrációs rangsort állítottak fel: Ag>Pb>Cu>Sn (értsd: az ezüst hibásodik meg leghamarabb). Ezt a sorrendet az un. oldhatósági szorzattal hozták összefüggésbe [9]: konkrétan a különböző fémhidroxidok (pl.: Sn(OH)2) oldhatósági szorzata és a meghibásodásig eltelt idő között erős korrelációt mutattak ki [9]. Mivel az ólom esetében nem tiszta fémet vizsgáltak, hanem forraszötvözetet, ezért felmerült a gyanú, hogy a felállított sorrend, nem biztos, hogy megállja helyét. Ez a vizsgálódás tulajdonképpen a különböző forrasztható fémbevonatok anyagválasztásának könnyítését célozza, hiszen nem mindegy, hogy migrációs szempontból egyik másik fémezés mennyire lesz megbízható a működés során. Az itteni eredmények alapján következő mondható ki:
Kimutattam, hogy az ólom és réz migrációs hajlamosságának sorrendje nem egyértelmű, a korábban publikált [9] és a hidroxidok oldhatósági szorzatának tulajdonított Ag>Pb>Cu>Sn sorrend bizonyos esetekben módosulhat: Ag>Cu>Pb>Sn. Ez ólomtartalmú ötvözet esetén az eutektikumképződésnek, ill. az abból való kioldódás gátoltságának, a réz esetében pedig a felületi oxidációs állapot oldhatóságot befolyásoló szerepének tudható be (lásd kapcsolódó publikációk).
Végül, de nem utolsó sorban alacsony ezüst tartalmú (költséghatékony), mikro ötvözőkkel ellátott forraszok migrációs vizsgálatait végeztem (vízcsepp teszt), ahol a meghibásodási idők meghatározásán túlmenően a kialakult dendritek és a tömbi forraszban képződött intermetallikusok szerkezetét és összetételét vizsgáltam, valamint a forrasz felületén kialakult passzív rétegek relatív oxidvastagságát is tanulmányoztam. Az eredmények nem véglegesek, de egyelőre az körvonalazódik, hogy a mikro ötvözők is részt vesznek az intermetallikus képződésben, ami az anódos oldódással, annak sebességével hozható összefüggésbe, vagyis szerepet játszik a meghibásodásig eltelt időben. A kialakult passzív rétegek is szerepet játszanak az oldódás gátoltságában, ennek mértékét a passzív réteg felületi mérete és annak vastagsága adja [10].
Várható impakt, további kutatás
Az elektrokémiai migráció az ólommentes forrasztás bevezetésével újra az egyik központi téma lett az elektronikai áramkörök, egységek és szerelvények megbízhatósági kérdéskörében. Az új anyagokat különböző hordozókon, különböző technológiákkal valósítják meg, és igen változó környezeti körülmények között üzemeltetik azokat. Ez önmagában akkora kihívás, hogy az elkövetkezendő évek kutatásait biztosan jelentős mértékben kitölti. Az elektrokémiai migrációs hajlamosság ugyanis számos tényezőtől függ (teljesség igénye nélkül): hordozó anyaga (porózusság, nedvszívó képesség), kontaktus felületek anyaga és azok felviteli eljárása, vezetősávok hídtávolsága, üzemi feszültség, nedvesség megjelenésének módja és annak mennyisége, összetétele és terülése, valamint a felületi, illetve nedvességszennyezők típusa, illetve azok koncentrációja, stb. A kutatások eredményeitől azt várom, hogy hasznos információt adnak az elektronikai ipar számára:gyártásnál például segíthetik a megfelelő anyagválasztást, a technológiai paraméterek optimális beállítását, és ezzel hozzájárulnak egy magasabb minőségi és megbízhatósági szinthez a termék teljes életciklusát tekintve.
Saját publikációk, hivatkozások, linkgyűjtemény
Kapcsolódó publikációk:
Lektorált, idegen nyelvű, külföldön megjelent folyóiratcikkek
Bálint Medgyes, Balázs Illés, Richárd Berenyi, Gábor Harsányi, In situ optical inspection of electrochemical migration during THB tests, JOURNAL OF MATERIALS SCIENCE-MATERIALS IN ELECTRONICS 22:(6) pp. 694-700. (2011) IF: 0.927*, WoS link, Scopus link, Teljes dokumentum, DOI: 10.1007/s10854-010-0198-4
Bálint Medgyes, Balázs Illés, Gábor Harsányi, Electrochemical migration behaviour of Cu, Sn, Ag and Sn63/Pb37, JOURNAL OF MATERIALS SCIENCE-MATERIALS IN ELECTRONICS 23:(2) pp. 551-556. (2012) IF: 0.927**, WoS link, Scopus link, Teljes dokumentum, DOI: 10.1007/s10854-011-0435-5
Referált, idegen nyelvű, nemzetközi konferencia-kiadványban megjelent előadás
Medgyes B, Berenyi R, Jakab L, Harsanyi G, Real-time monitoring of electrochemical migration during environmental tests, In: 32nd International Spring Seminar on Electronics Technology. Brno, Csehország, 2009.05.13-2009.05.17. (IEEE), pp. 1-6. WoS link, DOI: 10.1109/ISSE.2009.5207046
Medgyes B, Illés B, Contradictory Electrochemical Migration Behavior of Copper and Lead, In: 34th International Spring Seminar on Electronics Technology, ISSE2011. Tatranska Lomnica, Szlovákia, 2011.05.11-2011.05.15. (IEEE), pp. 206-211, Scopus link, Teljes dokumentum, Dokumentum a kiadónál, DOI: 10.1109/ISSE.2011.6053579
Teljes publikációs lista:
http://mycite.omikk.bme.hu/search/slist.php?lang=0&AuthorID=10005593
Külső hivatkozások listája
[1] Directive of the European Comission for the Reduction of Hazardous Substances, Directive 2000/0159 (COD) C5-487/2002, LEX 391, PE-CONS 3662/2/02 Rev 2, ENV581, CODEC 1273, 2003.
[2] D. Q. Yu, W. Jillek, E. Schmitt, Electrochemical migration of lead free solder joints, Journal of Materials Science - Materials in Electronics. 17, 229-241 (2006)
[3] J.Y Jung, S.B. Lee, H.Y. Lee, Electrochemical Migration Characteristics of Eutectic Sn-Pb Solder Alloy in NaCl and Na2SO4 Solutions, Journal of Electronic Materials. 38, 691-699 (2009)
[4] G. Harsányi, Electrochemical Processes Resulting in Migrated Short Failures in Microcircuits, IEEE Transactions on Components, Packaging, and Manufacturing Technology-Part A, 18(3), pp. 602-610 (1995)
[5] B.I. Noh, J. W. Yoon, W.S. Hong, Evaluation of Electrochemical Migration on Flexible Printed Circuit Boards with Different Surface Finishes, Journal of Electronic Materials. 38, 902-907 (2009)
[6] D. Minzari at al, Electrochemical migration of tin in electronics and microstructure of the dendrits, Corrosion Science 53, 1659–1669 (2011)
[7] S. Yang et al, Initial Stage of Silver Electrochemical Migration Degradation, Microelectronics Reliability 46, 1915–1921 (2006)
[8] Z. Sheng, M.H. Azarian, M. Pecht, Reliability of Printed Circuit Boards Processed Using No-Clean Flux Technology in Temperature Humidity Bias Conditions Device and Materials Reliability, IEEE Transactions on Device and Materials Reliability. 8, 426-434 (2008)
[9] G. Harsányi and G. Inzelt, Comparing Migratory Resistive Short Formation Abilities of Conductor Systems Applied in Advanced Interconnection Systems, Microelectronics Reliability 41, (2001)
[10] D. Q.Yu, W. Jillek, E. Schmitt, Electrochemical migration of Sn-Pb and lead free solder alloys under distilled water, Journal of Materials Science - Materials in Electronics, 17, 219-227 (2006)
[11] S. J. Krumbein, Tutorial: Electrolytic Models for Metallic Electromigration Failure Mechanisms, IEEE Transactions on Reliability, 44( 4), pp. 539-549 (I995)
